流程

IC Package (IC的封裝形式)指芯片(Die)和不同類型的框架(L/F)和塑封料(EMC)形成的不同外形的封裝體。
IC Package種類繁多,可按以下分類:
按封裝材料劃分為:
金屬封裝、陶瓷封裝、塑料封裝



金屬封裝主要用于軍工或航天技術,無商業化產品;
陶瓷封裝優于金屬封裝,也用于軍事產品,占少量商業化市場;
塑料封裝用于消費電子,其成本低,工藝簡單,可靠性高而占有絕大部分的市場份額;
按照和PCB板連接方式分為:
PTH封裝和SMT封裝


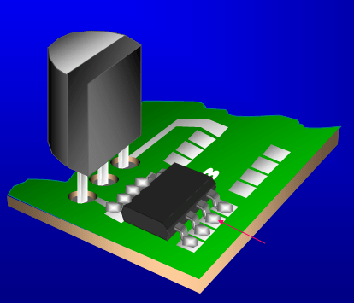
PTH-Pin Through Hole, 通孔式;
SMT-Surface Mount Technology,表面貼裝式。
目前市面上大部分IC均采為SMT式的
按照封裝外型可分為:
SOT、SOIC、TSSOP、QFN、QFP、BGA、CSP等;
決定封裝形式的兩個關鍵因素:
封裝效率。芯片面積/封裝面積,盡量接近1:1;
引腳數。引腳數越多,越高級,但是工藝難度也相應增加;
其中,CSP由于采用了Flip Chip技術和裸片封裝,達到了 芯片面積/封裝面積=1:1,為目前最高級的技術;
QFN—Quad Flat No-lead Package 四方無引腳扁平封裝
SOIC—Small Outline IC 小外形IC封裝
TSSOP—Thin Small Shrink Outline Package 薄小外形封裝
QFP—Quad Flat Package 四方引腳扁平式封裝
BGA—Ball Grid Array Package 球柵陣列式封裝
CSP—Chip Scale Package 芯片尺寸級封裝
IC Package Structure(IC結構圖)
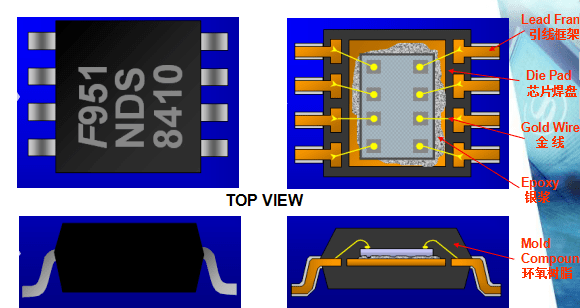
Raw Material in Assembly(封裝原材料)【Wafer】晶圓

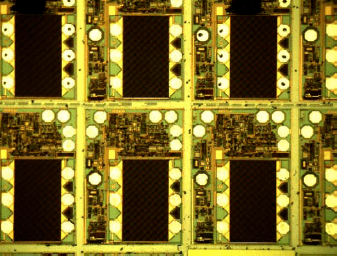
【Lead Frame】引線框架
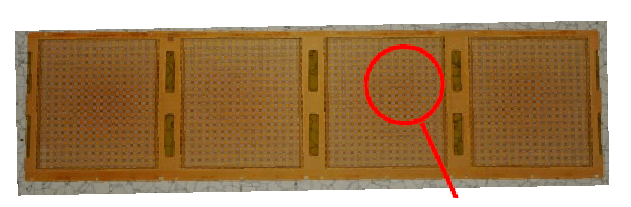
提供電路連接和Die的固定作用;
主要材料為銅,會在上面進行鍍銀、 NiPdAu等材料;
L/F的制程有Etch和Stamp兩種;
易氧化,存放于氮氣柜中,濕度小 于40%RH;
除了BGA和CSP外,其他Package都會采用Lead Frame, BGA采用的是Substrate;
【Gold Wire】焊接金線

實現芯片和外部引線框架的電性和物 理連接;
金線采用的是99.99%的高純度金;
同時,出于成本考慮,目前有采用銅 線和鋁線工藝的。優點是成本降低, 同時工藝難度加大,良率降低;
線徑決定可傳導的電流;0.8mil, 1.0mil,1.3mils,1.5mils和2.0mils;
Mold Compound塑封料/環氧樹脂主要成分為:環氧樹脂及各種添加劑(固化劑,改性劑,脫 模劑,染色劑,阻燃劑等);
主要功能為:在熔融狀態下將Die和Lead Frame包裹起來, 提供物理和電氣保護,防止外界干擾;
存放條件:零下5°保存,常溫下需回溫24小時;
【Epoxy】銀漿

成分為環氧樹脂填充金屬粉末(Ag);有三個作用:將Die固定在Die Pad上; 散熱作用,導電作用;
-50°以下存放,使用之前回溫24小時;
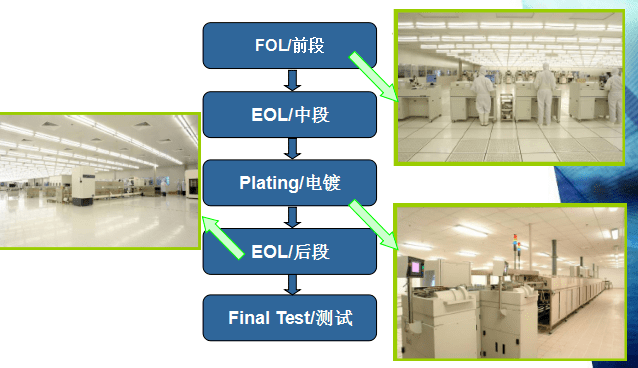
FOL– Front of Line前段工藝
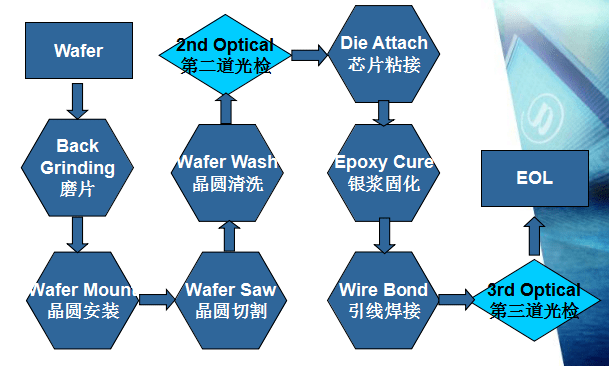
FOL– Back Grinding背面減薄
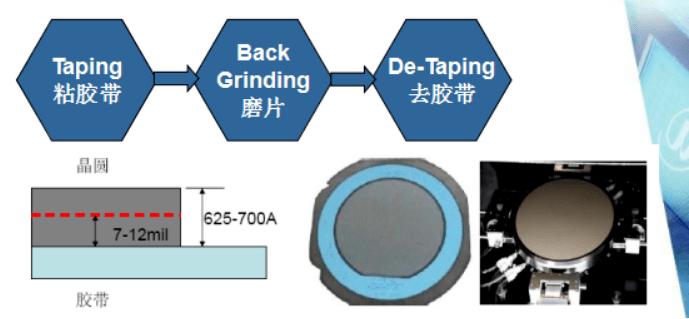
將從晶圓廠出來的Wafer進行背面研磨,來減薄晶圓達到 封裝需要的厚度(8mils~10mils);
磨片時,需要在正面(Active Area)貼膠帶保護電路區域 同時研磨背面。研磨之后,去除膠帶,測量厚度;
FOL– Wafer Saw晶圓切割
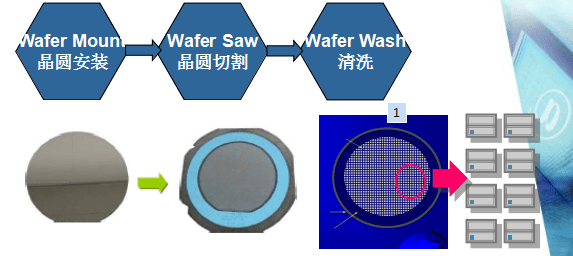
將晶圓粘貼在藍膜(Mylar)上,使得即使被切割開后,不會散落;
通過Saw Blade將整片Wafer切割成一個個獨立的Dice,方便后面的 Die Attach等工序;
Wafer Wash主要清洗Saw時候產生的各種粉塵,清潔Wafer;
FOL– 2nd Optical Inspection二光檢查


主要是針對Wafer Saw之后在顯微鏡下進行Wafer的外觀檢查,是否有出現廢品。
FOL– Die Attach 芯片粘接
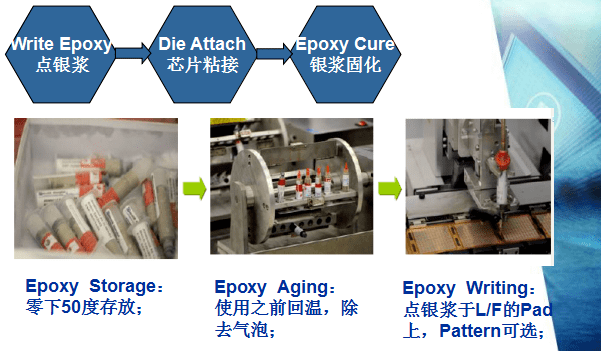
芯片拾取過程:
1、Ejector Pin從wafer下方的Mylar頂起芯片,使之便于 脫離藍膜;
2、Collect/Pick up head從上方吸起芯片,完成從Wafer 到L/F的運輸過程;
3、Collect以一定的力將芯片Bond在點有銀漿的L/F 的Pad上,具體位置可控;
4、Bond Head Resolution:X-0.2um;Y-0.5um;Z-1.25um;
5、Bond Head Speed:1.3m/s;
FOL– Epoxy Cure 銀漿固化
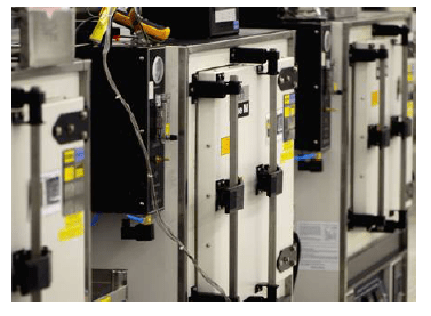
銀漿固化:
175°C,1個小時; N2環境,防止氧化:

Die Attach質量檢查:
Die Shear(芯片剪切力)
FOL– Wire Bonding 引線焊接

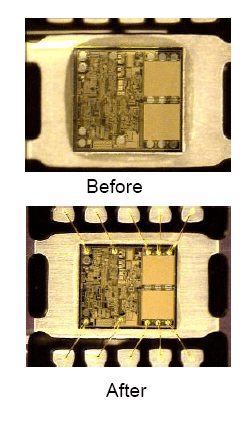
利用高純度的金線(Au) 、銅線(Cu)或鋁線(Al)把 Pad 和 Lead通過焊接的方法連接起來。Pad是芯片上電路的外接 點,Lead是 Lead Frame上的 連接點。
W/B是封裝工藝中最為關鍵的一部工藝。
FOL– 3rd Optical Inspection三光檢查
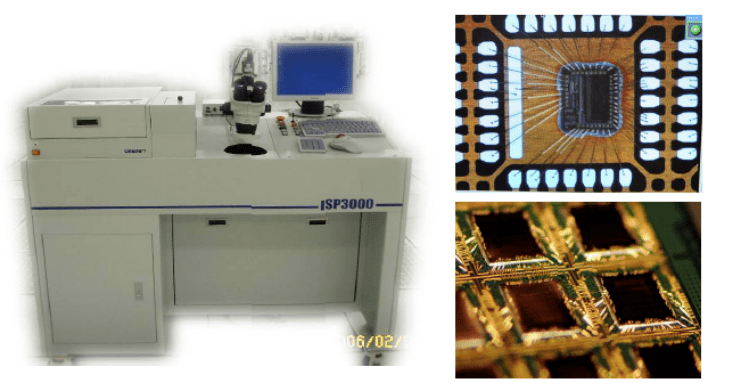
EOL– End of Line后段工藝
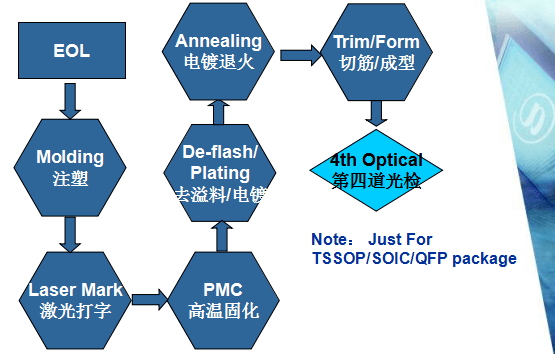
EOL– Molding(注塑)

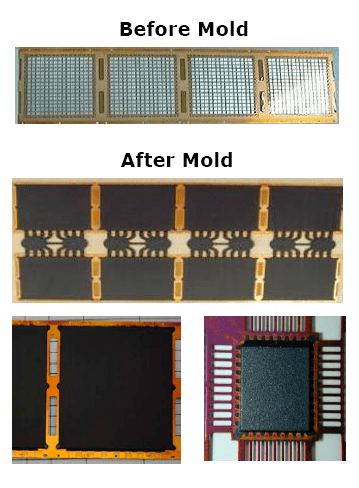
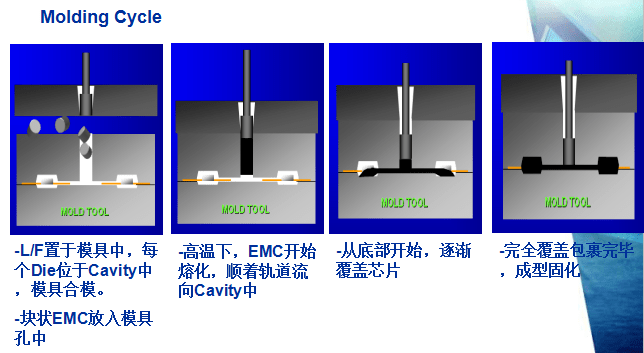
EOL– Laser Mark(激光打字)
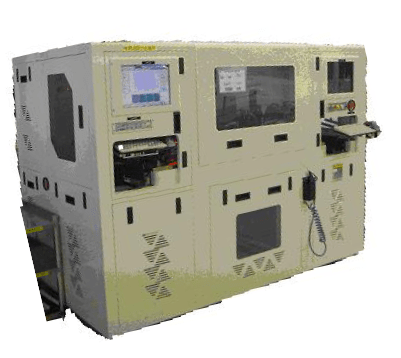
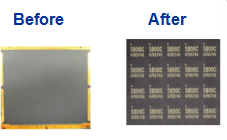
在產品(Package)的正面或者背面激光刻字。內容有:產品名稱,生產日期,生產批次等;
EOL– Post Mold Cure(模后固化)


用于Molding后塑封料的固化,保護IC內部結構,消除內部應力。Cure Temp:175+/-5°C;Cure Time:8Hrs
EOL– De-flash(去溢料)
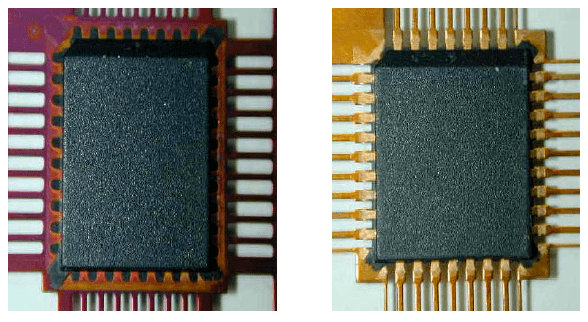
目的:De-flash的目的在于去除Molding后在管體周圍Lead之間 多余的溢料; 方法:弱酸浸泡,高壓水沖洗;
EOL– Plating(電鍍)
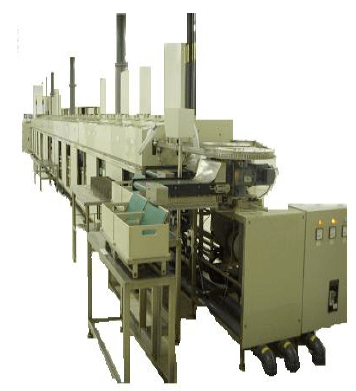
利用金屬和化學的方法,在Leadframe的表面 鍍上一層鍍層,以防止外界環境的影響(潮濕 和熱)。并且使元器件在PCB板上容易焊接及 提高導電性。
電鍍一般有兩種類型:
Pb-Free:無鉛電鍍,采用的是>99.95%的高純 度的錫(Tin),為目前普遍采用的技術,符合 RoHS的要求;
Tin-Lead:鉛錫合金。Tin占85%,Lead占 15%,由于不符合 RoHS,目前基本被淘汰;
EOL– Post Annealing Bake(電鍍退火)

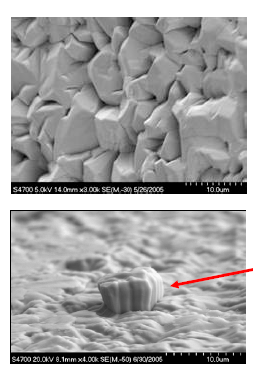
目的:讓無鉛電鍍后的產品在高溫下烘烤一段時間,目的在于 消除電鍍層潛在的晶須生長(Whisker Growth)的問題; 條件:150+/-5C; 2Hrs;
EOL– Trim&Form(切筋成型)

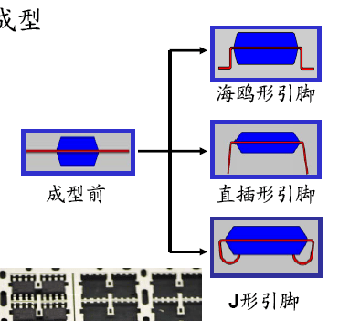
Trim:將一條片的Lead Frame切割成單獨的Unit(IC)的過程; Form:對Trim后的IC產品進行引腳成型,達到工藝需要求的形狀, 并放置進Tube或者Tray盤中;
EOL– Final Visual Inspection(第四道光檢)

在低倍放大鏡下,對產品外觀進行檢查。主要針對EOL工藝可能產生的廢品:例如Molding缺陷,電鍍缺陷和Trim/Form缺陷等;

