

很多針對(duì)半導(dǎo)體和集成電路 (IC) 封裝的熱度量的范圍介于 θja 至 Ψjt之間。 通常情況下,這些熱度量被很多 用戶錯(cuò)誤的應(yīng)用于估計(jì)他們系統(tǒng)中的結(jié)溫。 本文檔描述了傳統(tǒng)和全新的熱度量,并將它們應(yīng)用于系統(tǒng)級(jí)結(jié)溫 估算方面。
結(jié)至環(huán)境熱阻,θja,是最常見(jiàn)的報(bào)告的熱度量,它也是最經(jīng)常被誤用的。θja是安裝在特定測(cè)試試件上 IC 封 裝散熱性能的度量。 θja的目的是給出一個(gè)封裝的相對(duì)散熱性能可與之進(jìn)行比較的度量值。 因此,TI 器件的 散熱性能可以與其他公司生產(chǎn)的器件相比較。 當(dāng)兩家公司使用標(biāo)準(zhǔn)化測(cè)試來(lái)測(cè)量 θja時(shí),這是可行 的,JEDEC 在 EIA/JESD 51 系列文檔中具體說(shuō)明了此類(lèi)測(cè)試。 然而,有時(shí)并未遵循 JEDEC 條件,并且對(duì) 于標(biāo)準(zhǔn)的偏離也未記錄在案。 這些測(cè)試變化會(huì)對(duì) θja的測(cè)得值產(chǎn)生很大的影響。 因此,除非使用 θja值來(lái)公布 測(cè)試條件,否則這些測(cè)試條件值得懷疑。
使用以下步驟來(lái)執(zhí)行 θja測(cè)量(總結(jié)自 EIA/JESD 51-1):
Step 1. 一個(gè)部件,通常是一個(gè)安裝在測(cè)試版上的集成電路 (IC) 封裝,此封裝包含一個(gè)能夠耗散功率并 測(cè)量最大芯片溫度。
Step 2. 測(cè)試芯片的溫度感測(cè)組件被校準(zhǔn)。
Step 3. 封裝/測(cè)試版/系統(tǒng)被放置在一個(gè)不通風(fēng) (θja) 或空氣流通 (θma) 環(huán)境中。
Step 4. 一個(gè)已知功率在測(cè)試芯片內(nèi)耗散。
Step 5. 在達(dá)到穩(wěn)定狀態(tài)后,結(jié)溫被測(cè)量。
Step 6. 已測(cè)得的環(huán)境溫度與測(cè)得的結(jié)溫之間的差異被計(jì)算出來(lái),并除以耗散的功率,從而得出一個(gè)以 °C/W 為單位的 θja值。
很不幸的是,θja常常被系統(tǒng)設(shè)計(jì)人員用來(lái)估算他們系統(tǒng)中所使用的器件的結(jié)溫。 這個(gè)等式通常被認(rèn)為可有效 地根據(jù) θja來(lái)計(jì)算結(jié)溫:
![]()
這是 θja熱參數(shù)的誤用,這是因?yàn)?θja是一個(gè)并不專(zhuān)屬于封裝的可變函數(shù),它也是諸如已安裝部件上印刷電路板 (PCB) 的設(shè)計(jì)和布局布線等很多其它系統(tǒng)級(jí)特性的函數(shù)。 實(shí)際上,測(cè)試板是一個(gè)焊接在器件引線上的散 熱片。 對(duì)測(cè)試板的設(shè)計(jì)或配置的改變將改變散熱片的效率,并因此改變 θja。 事實(shí)上,在不通風(fēng)的環(huán)境 中,JEDEC 定義的 θja測(cè)量,大約芯片產(chǎn)生的功率的 70-95% 由測(cè)試板耗散,而不是從封裝的表面散發(fā)。 由 于系統(tǒng)板很少接近被用來(lái)確定 θja的測(cè)試試件,θja使用公式 1的應(yīng)用將導(dǎo)致極端錯(cuò)誤的值。 表 1列出了在所有材料保持恒定時(shí),將影響指定封裝外形尺寸內(nèi) θja的因數(shù)。 第一列列出了因數(shù),而第二列 給出了憑經(jīng)驗(yàn)法則估算出的此因數(shù)所造成的影響。

根據(jù) θja并不是封裝本身的特性,而是封裝,PCB 和其它環(huán)境因素的特性這一事實(shí),它最好用作不同公司的 封裝散熱性能的對(duì)照。 例如,如果相對(duì)于競(jìng)爭(zhēng)對(duì)手所公布的 45°C/W 值,TI 針對(duì)一個(gè)封裝公布了一個(gè)
40°C/W 的 θja值,那么 TI 部件在應(yīng)用中有可能比競(jìng)爭(zhēng)對(duì)手的部將多冷卻 10%。
最近,JEDEC 已經(jīng)建立了一組標(biāo)準(zhǔn)用來(lái)測(cè)量并報(bào)告 IC 封裝的散熱性能。 這些標(biāo)準(zhǔn)全部屬于 EIA/JESD 51項(xiàng)下。 EIA/Semi 也具有一組與 JEDEC 版本完全不同的熱標(biāo)準(zhǔn)。 由于 θja不是一個(gè)常量,所以在嘗試一個(gè)比 較前,確定用來(lái)計(jì)算或測(cè)量 θja的標(biāo)準(zhǔn)就變得十分關(guān)鍵。 在 JEDEC 技術(shù)規(guī)范內(nèi),允許兩個(gè)測(cè)試板類(lèi)型。 一個(gè) 1s(單信號(hào)層)配置給出了一個(gè)針對(duì)適度板上組裝、 多層系統(tǒng)級(jí) PCB 應(yīng)用的典型使用值。 一個(gè) 2s2p(雙信號(hào)層、雙隱蔽式電源層)配置給出了一個(gè)最佳情況 性能估算,假定采用了具有隱蔽式電源和接地層的稀疏板上組裝、高走線密度板設(shè)計(jì)。圖 1顯示了對(duì)于 17中不同封裝類(lèi)型,針對(duì)這兩個(gè)電路板的 θja差異。 請(qǐng)注意,針對(duì)這些模型,所有材料和封裝幾何圖形保持恒定。
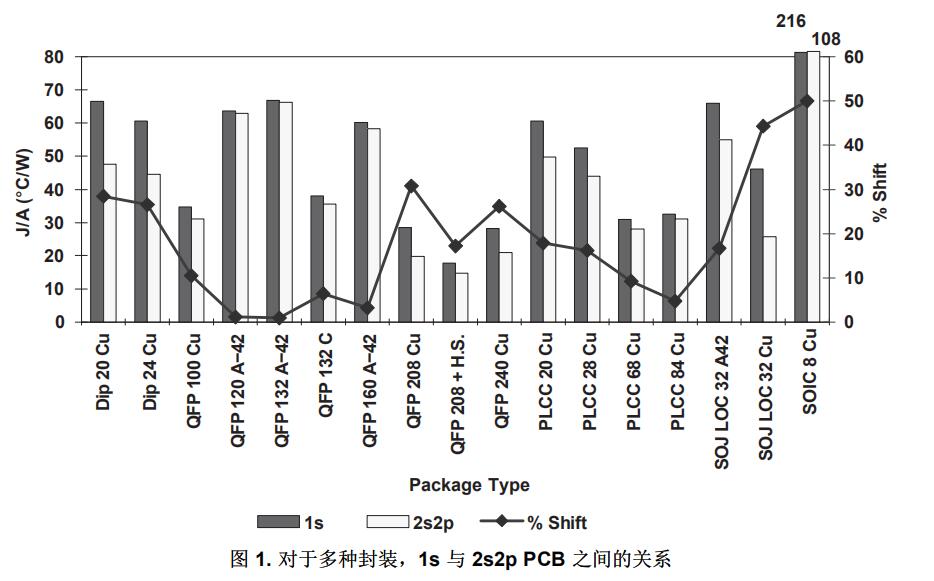
圖 1. 對(duì)于多種封裝,1s 與 2s2p PCB 之間的關(guān)系 如圖所示,單單一個(gè) 1s 與 2s2p 測(cè)試卡結(jié)構(gòu)間關(guān)系的函數(shù)即可產(chǎn)生最多 50% 的 θja變化。
如果芯片或基板足夠大的話,一個(gè)封裝內(nèi)的芯片或裸片基板都可發(fā)揮均熱片的功能。 這個(gè)均熱片有兩重功 效。 首先,它將能量從芯片熱點(diǎn)分散到封裝表面上更廣闊的面積上,從而增加對(duì)流能量損耗。 第二,它增 加了基板到引線指或封裝焊球的熱傳輸,然后將熱量傳導(dǎo)至 PCB。圖 2顯示了卷帶式空間陣列芯片級(jí)封裝(CSP) 中芯片尺寸對(duì) θja 的影響。 如圖所示,針對(duì)此封裝的 θja隨芯片尺寸變化了大約 8 倍。 如果計(jì)劃縮小 芯片尺寸,那么很有必要重新測(cè)量或重新計(jì)算一個(gè)封裝的 θja。
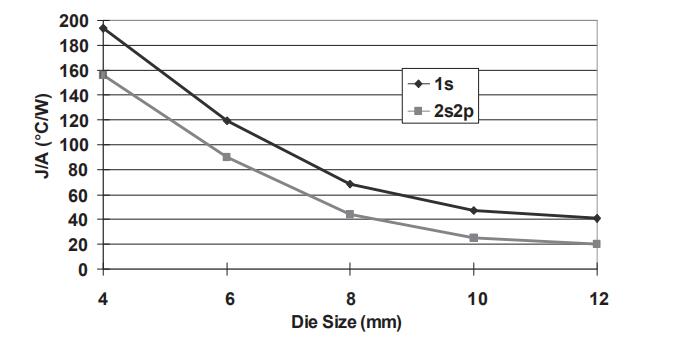
圖 2. 芯片尺寸對(duì) CSP 的影響
這個(gè)話題是指一個(gè)封裝內(nèi)的布局布線,不管它是一個(gè)傳統(tǒng)的引線框架封裝、小型基板(S 基板)封裝、引線 片載 (LOC) 或球狀引腳柵格陣列 (BGA) 封裝。 越來(lái)越多普通的幾何形狀也可以對(duì)封裝散熱性能產(chǎn)生主要的 影響。 這些可以包括如圖 3中所示的封裝中引線頂端與芯片基板間的距離,或者甚至是基板和引線指之間的 引線框架。 后者是薄型封裝中特別重要的熱標(biāo)準(zhǔn)。 在 BGA 封裝中,內(nèi)插板走線布局在將熱量從芯片分散至 封裝焊球,再傳導(dǎo)至 PCB,的過(guò)程中十分重要。

圖 3. J/A 與 引腳到基板距離間的關(guān)系
由于周?chē)h(huán)境的空氣壓力隨著海拔的變化而變化,空氣的冷卻效率也在發(fā)生變化。 IBM [1]曾經(jīng)證明在海拔8000 英尺高運(yùn)行的器件會(huì)比在海平面上運(yùn)行的器件熱 20%。 其它調(diào)查已經(jīng)顯示當(dāng)在不同的海拔使用器件 時(shí),風(fēng)扇性能和內(nèi)部底板空氣流動(dòng)會(huì)有很大變化。 應(yīng)該將這些影響考慮在內(nèi),特別是當(dāng)未從散熱的角度考慮 系統(tǒng)設(shè)計(jì)時(shí)更是如此。 很多主要的系統(tǒng)公司具有壓力室以便在不同的有效海拔來(lái)測(cè)試他們的系統(tǒng)。 通常情 況下,這些公司用器件裝備他們的設(shè)計(jì)來(lái)測(cè)量器件運(yùn)行在不同分壓下的內(nèi)部組件溫度。表 2列出了取自 IBM公司的倍增因數(shù)來(lái)降低 θja額定值:

由于空氣的密度、粘度和熱容量隨著溫度的變化而變化,所以當(dāng)我們發(fā)現(xiàn) θja隨著周?chē)鷾囟鹊淖兓兓瘯r(shí)就 不應(yīng)感到意外了。 TI 熱實(shí)驗(yàn)室中的試驗(yàn)顯示當(dāng)在 0-100°C 的環(huán)境溫度范圍內(nèi)測(cè)量時(shí),θja會(huì)提升 10-20% –也 就是說(shuō),100°C 環(huán)境溫度中的 θja大約比 0°C 環(huán)境溫度中的 θja提升 20%。
器件的表面溫度促使封裝的對(duì)流和輻射能量損失。 封裝表面變得越熱,到周?chē)h(huán)境的對(duì)流和輻射熱損耗就越 有效。 因此,當(dāng)封裝的功率加倍時(shí),θja提升了大約 3% 這一情況就很正常了。 對(duì)于極低功率耗散,θja有時(shí) 比額定封裝功率水平高 2-3 倍。
Theta-ja (θja) 是一個(gè)系統(tǒng)級(jí)參數(shù),這個(gè)參數(shù)在很大程度上取決于上面部分中所描述的系統(tǒng)參數(shù);因此,有時(shí) 定義一個(gè) Theta-ja 效用, θjaeffective,會(huì)比較有用,這只是運(yùn)行在相關(guān)系統(tǒng)中的器件的 θja。 如果θjaeffective可以 從系統(tǒng)中的熱建模或測(cè)量中估算的話,可使用公式 1來(lái)計(jì)算結(jié)溫,前提是系統(tǒng)上周?chē)M件的功率不發(fā)生變 化。然后公式 1變成:
![]()
導(dǎo)致一個(gè) θjaeffective的系統(tǒng)條件應(yīng)該在報(bào)告一個(gè) θjaeffective時(shí)始終被定義。
結(jié)至外殼熱阻度量最開(kāi)始是設(shè)計(jì)用來(lái)在散熱片被連接后估算一個(gè)封裝的散熱性能。 JEDEC JESD51.1 規(guī) 定,Theta-jc 是“一個(gè)半導(dǎo)體器件的運(yùn)行部分到最近接芯片安裝區(qū)域的封裝(外殼)表面的熱阻,此時(shí)同一表 面被適當(dāng)散熱以大大減少表面上的溫度變化。” 雖然現(xiàn)在沒(méi)有定義 θjc的可用 JEDEC 技術(shù)規(guī)范,但是確實(shí)有 一個(gè)非常通用的測(cè)量 θjc的行業(yè)做法。 在以下部分中描述了這個(gè)做法。 SEMI 標(biāo)準(zhǔn) G43-87 描述了一個(gè)測(cè)量 θjc的液體浸入方法。 雖然 TI 已經(jīng)在過(guò)去使用了這個(gè)方法,它只具有歷史價(jià)值,而并不在這里詳述。
這個(gè)方法強(qiáng)制幾乎所有測(cè)試器件的功率通過(guò)一個(gè)已定義的封裝表面。 根據(jù)器件上散熱片的安裝方法,這也許 是封裝的最底層。 總的來(lái)說(shuō),它是封裝的頂層表面。θjc在確定芯片和安裝散熱片的表面之間熱阻方面比較有 用。總結(jié)起來(lái),此過(guò)程是:
Step 1. 通常包含一個(gè)熱測(cè)試芯片的 IC 封裝被安裝在一個(gè)測(cè)試 PCB 上,它通常是 1s JEDEC 定義的測(cè) 試板。
Step 2. 當(dāng)外殼頂部被測(cè)量時(shí),此封裝在一個(gè)dead bug布局中與一個(gè)純銅冷卻盤(pán)(一個(gè)具有循環(huán)恒定溫 度液體的純銅塊)壓配。 否則,當(dāng)封裝的主冷卻路徑通過(guò)一個(gè)焊接盤(pán)進(jìn)入 PCB 時(shí),一個(gè)到封 裝底部的純銅冷卻盤(pán)觸點(diǎn)通過(guò) PCB 提供。
Step 3. 硅樹(shù)脂散熱油脂或其他散熱接口材料提供冷卻盤(pán)與封裝間的散熱連接。
Step 4. 在測(cè)試試件周?chē)峁┝烁魺嵋源蟠蠼档图纳鸁釗p耗。
Step 5. 為器件加電。
Step 6. 測(cè)試芯片的結(jié)溫被測(cè)量。
Step 7. 通過(guò)壓在這個(gè)表面上的熱電偶或其它溫度傳感器,與冷卻盤(pán)接觸的封裝表面的溫度被測(cè)量。
Step 8. 通過(guò)將測(cè)得的溫度 delta 除以已耗散的功率來(lái)計(jì)算 θjc。

之前對(duì) θjc已過(guò)時(shí)的理解顯示在公式 3中。
![]()
在這里,被報(bào)告的封裝散熱性能 θja是兩個(gè)電阻,θjc和 θca的和。θca代表外殼至環(huán)境熱阻,它由這個(gè)等式定 義。 對(duì)于具有金屬罐的封裝,這也許是個(gè)有效的等式,在這類(lèi)封裝中,溫度相對(duì)恒定,與 PCB 沒(méi)有熱連 接。 但是,這些條件并不適用于當(dāng)今與 PCB 緊密連接的塑料或陶瓷封裝。 在現(xiàn)在的封裝中,大散熱變化率 很常見(jiàn),所以公式 3的意義值得商榷。 一個(gè)傳統(tǒng)的,但是無(wú)效的,θjc的用法就是計(jì)算運(yùn)行在一個(gè)系統(tǒng)中的芯片的結(jié)溫。 運(yùn)行在系統(tǒng)中的器件外殼溫 度使用熱電偶,IR 攝像頭或熒光探測(cè)器。 下面的等式被錯(cuò)誤地用來(lái)計(jì)算結(jié)溫:公式 4:
![]()
這里的錯(cuò)誤在于,在典型塑料封裝中,只有一小部分熱能量從封裝的頂部對(duì)流和輻射出去。 很多模型已經(jīng)顯 示,芯片 60-95% 的熱能量從封裝連接的 PCB 上對(duì)流和輻射出去。 如果用戶認(rèn)為全部功率從頂部表面耗散 的話,用公式 4計(jì)算出的結(jié)溫要高于實(shí)際溫度。 在具有熱工裕量的設(shè)計(jì)中,這是個(gè)麻煩,但是在沒(méi)有熱工裕 量的設(shè)計(jì)中,可采取錯(cuò)誤限制。 θjc的這個(gè)限制被全新的熱度量,Ψjt,所克服,在下面對(duì)它進(jìn)行說(shuō)明。 公式 5顯示了 θjc針對(duì)這些實(shí)例的適當(dāng)應(yīng)用,此時(shí)一個(gè)高效散熱片被應(yīng)用到器件的頂部,對(duì)于這個(gè)器件,θjc比 θja小:

在這里,θsa是散熱片的散熱片至環(huán)境性能,而 θcs是散熱連接材料的外殼至散熱片熱阻(請(qǐng)見(jiàn)公式 7)。 環(huán) 境溫度是用于描述 θsa特性的位置,通常距離散熱片有一定的距離。 這個(gè)等式是針對(duì)封裝對(duì)準(zhǔn)確的等式,在 這里,θjc比 θja小,這意味著當(dāng)采用充足有效的散熱片時(shí),大多數(shù)熱量可以通過(guò)封裝的表面散發(fā)出去。 公式 6顯示了一個(gè)比公式 5θja,θjc或 θsa的任一組合更加準(zhǔn)確的近似值,如果 θja對(duì)系統(tǒng)配置已知的話:

θcs的最好方法是實(shí)際測(cè)量 θcs值,但是如果這是不可能的話,公式 7可被用來(lái)估算 θcs。 請(qǐng)注意,由于 忽略了任意兩個(gè)表面之間可產(chǎn)生的熱連接電阻,這僅僅是一個(gè)估算值。

其中:
T = 封裝和散熱片之間連接層的厚度
K= 熱連接材料的總體散熱傳導(dǎo)率
A = 散熱連接材料的應(yīng)用面積
某些封裝具有諸如散熱塊或外露墊等構(gòu)造,這些構(gòu)造為封裝的頂部,底部或上下端散熱。 當(dāng)只有單個(gè)表面用 于散熱時(shí),根據(jù) JEDEC JC51.1 技術(shù)規(guī)范,這個(gè)表面就是將被用于 Theta-jc 的表面。 某些時(shí)候,設(shè)計(jì)人員 希望也將封裝頂部的散熱片包括在內(nèi),雖然外露墊被焊接到 PCB 上。 在這樣的實(shí)例中,為了避免在提及表 面時(shí)造成的混淆,對(duì) Theta-jc 頂部 (θjctop) 和 Theta-jc 底部 (θjcbottom) 進(jìn)行定義是適當(dāng)?shù)淖龇ā?頂部表面是背 對(duì)著 PCB 的封裝表面,而底部表面是面對(duì) PCB 的封裝表面。 當(dāng) θjcbottom被測(cè)量時(shí),制作了一個(gè)具有切口的 特殊 PCB 以實(shí)現(xiàn)底部封裝表面與純銅冷卻盤(pán)的接觸。 當(dāng)與純銅冷卻盤(pán)接觸時(shí),封裝底部表面讀取的溫度成 為外殼溫度,這個(gè)溫度用來(lái)計(jì)算外殼和芯片結(jié)溫之間的溫度 delta。
應(yīng)該注意的是,德州儀器 (TI) 有時(shí)已經(jīng)使用 Theta-jp 或結(jié)至外露墊的命名法,來(lái)表示結(jié)點(diǎn)與封裝外露墊之 間的熱阻。 不論這個(gè)墊是暴露在封裝的頂部或底部,這個(gè)命名法都已經(jīng)被使用。
在一次為用戶社區(qū)提供熱度量以從測(cè)得的外殼溫度估算使用中的結(jié)溫的嘗試中,一個(gè)全新的熱度量,Ψjt,已 經(jīng)被業(yè)界采用 (EIA/JESD 51-2)。 這個(gè)度量由希臘字母 Psi(Ψ) 而不是 Theta (θ) 定義,這是因?yàn)?Ψjt不是真正地?zé)嶙琛?br/>下面從 EIA/JESD 51-2 中總結(jié)了 Ψjt 的測(cè)量過(guò)程:
Step 1. 在一個(gè)測(cè)試板上安裝一個(gè)測(cè)試封裝,此封裝通常包含一個(gè)散熱測(cè)試芯片。
Step 2. 將一個(gè)細(xì)規(guī)度熱電偶導(dǎo)線(36 規(guī)度或更小)黏結(jié)到封裝的頂部中央。
Step 3. 沿著封裝來(lái)熱電偶導(dǎo)線以大大減少熱電偶的散熱性。
Step 4. 在測(cè)試芯片中耗散功率。
Step 5. 測(cè)量測(cè)試芯片結(jié)溫和熱電偶溫度。
Step 6. 將結(jié)溫和表面溫度間的散熱變化率除以耗散的功率。
為什么 Ψjt不是一個(gè)真正的熱阻? 在上面的過(guò)程中,測(cè)試芯片所產(chǎn)生的熱能量被允許沿著優(yōu)先散熱傳導(dǎo)路徑 正常流動(dòng)。 從芯片流動(dòng)到封裝頂部的熱量在測(cè)量中是未知的,但是假定為器件的總功率,以實(shí)現(xiàn) Ψjt計(jì)算的 目的。 很明顯,這個(gè)假設(shè)是無(wú)效的,但是當(dāng)用這種方法進(jìn)行計(jì)算時(shí),Ψjt成為一個(gè)非常有用的數(shù),這是因?yàn)?此試驗(yàn)配置與 IC 封裝的應(yīng)用環(huán)境十分類(lèi)似。 這樣的話,測(cè)試期間,從芯片流向封裝頂部的能量數(shù)量與流進(jìn) 一個(gè)應(yīng)用環(huán)境中的能量分割類(lèi)似。 與公式 4相比,使用公式 8可以非常接近地估算實(shí)際結(jié)溫。
![]()
對(duì)于塑料封裝,相對(duì)于 4-15°C/W 的 θjc值, Ψjt的典型值為 0.5-2.0°C/W。較薄的封裝具有比較厚封裝更小 的 Ψjt值。 具有嵌入式散熱塊的封裝的 Ψjt值接近為零。 您應(yīng)該注意到,Ψjt隨著電路板結(jié)構(gòu)和空氣流通情況 的變換而變化,如表 3中所示。 這些值通過(guò)建模獲得。

外殼溫度被定義為器件頂上最熱的溫度。 在大多數(shù)實(shí)例中,這是器件的頂部中心或器件的蓋子。 可使用一 個(gè)紅外 (IR) 攝像機(jī)、熒光探測(cè)器、熱電偶或 IR 槍式探測(cè)器(具有 4mm 直徑的最大觀察視野)來(lái)執(zhí)行外殼 溫度測(cè)量(為了實(shí)現(xiàn)準(zhǔn)確性),提及這些測(cè)量設(shè)備只是為了列舉幾個(gè)技術(shù)。 當(dāng)熱電偶被選中作為執(zhí)行測(cè)量的 技術(shù)時(shí),應(yīng)該使用細(xì)規(guī)度導(dǎo)線(36 至 40 規(guī)度,J 或 K 線)以大大減少熱電偶的局部冷卻。 您應(yīng)該意識(shí) 到,如果外殼溫度由大于 36 的規(guī)度熱電偶測(cè)量,熱電偶吸收表面的熱量,冷卻正在被測(cè)量的位置,從而使 公式 8的計(jì)算無(wú)效。 使用一個(gè)大規(guī)度熱電偶來(lái)測(cè)量封裝頂部表面所帶來(lái)的影響是可觀的,從而將環(huán)境和實(shí)際 表面溫度之間的 delta 減少 50% 或者更多。 即使當(dāng) 36 規(guī)度或者更小熱電偶被采用時(shí),也會(huì)有錯(cuò)誤發(fā)生。
如果正在使用一個(gè)熱電偶,它應(yīng)該被接至封裝表面的中央 (±1mm),一側(cè)上的熱傳導(dǎo)環(huán)氧樹(shù)脂的微珠小于等 于 2mm x 2mm。 不建議將熱電偶捆扎在封裝表面。 為了大大減少熱電偶的散熱性,導(dǎo)線應(yīng)該沿著封裝的 對(duì)角線穿過(guò),向下到達(dá) PCB 表面,并且在從 PCB 豎起前長(zhǎng)度要超過(guò) 25mm。 通過(guò)使用膠帶可將熱電偶導(dǎo) 線釘在 PCB 上以實(shí)現(xiàn)這個(gè)走線的目的。 熱電偶導(dǎo)線規(guī)度的不正確使用會(huì)導(dǎo)致 5-50% 的測(cè)量錯(cuò)誤。 當(dāng)使用一個(gè) IR 攝像機(jī)或 IR 槍式探測(cè)器時(shí),請(qǐng)確保根據(jù)被測(cè)量表面的發(fā)射率來(lái)校正讀數(shù)。 詳細(xì)信息請(qǐng)參見(jiàn) 您的工具文檔。 由于散熱片覆蓋了將被測(cè)量的表面,所以測(cè)量應(yīng)用了散熱片的外殼溫度意味著特別的挑戰(zhàn)。 如果您希望在應(yīng) 用了散熱片的表面上測(cè)量外殼溫度,建議使用以下步驟。
Step 1. 在散熱片上鉆一個(gè)直徑 1mm 或更小的孔,當(dāng)散熱片被連接上時(shí),使這個(gè)孔位于封裝的中央。 一定要在將散熱片連接到封裝之前在散熱片上打孔。 如果壓敏黏合劑被用來(lái)固定散熱片,請(qǐng)打 孔鉆過(guò)這個(gè)黏合劑。 請(qǐng)確保沒(méi)有金屬毛邊或其他材料干擾貼合表面。
Step 2. 將散熱片貼在封裝上。 如果環(huán)氧樹(shù)脂被用來(lái)散熱片黏貼,用蠟、泡沫或其他材料填充步驟 1 中 鉆出的孔以確保這個(gè)孔不會(huì)被環(huán)氧樹(shù)脂填滿。 請(qǐng)小心,不要使這個(gè)材料污染散熱片黏貼表面。
Step 3. 用散熱油脂來(lái)填充這個(gè)孔。 如果這個(gè)孔被塞住以避免環(huán)氧樹(shù)脂填充,請(qǐng)一定清空這個(gè)孔。
Step 4. 將一個(gè)上面描述的細(xì)規(guī)度熱電偶穿過(guò)這個(gè)孔,并且用一滴環(huán)氧樹(shù)脂或膠帶固定。
當(dāng)打算應(yīng)用散熱片時(shí),不應(yīng)使用 Ψjt。 而應(yīng)使用公式 5和公式 6。
結(jié)至電路板熱阻,或結(jié)至引腳熱阻,嘗試用一個(gè)數(shù)字表示封裝和電路板之間的熱阻。 現(xiàn)實(shí)中,結(jié)至電路板熱 阻是分布的,具有不同的電阻路徑,例如結(jié)至引腳至電路板以及結(jié)通過(guò)塑料通過(guò)空氣至電路板。 然而,一個(gè) 諸如 θjb的單熱度量在根據(jù)以下簡(jiǎn)單 3 電阻器散熱近似值來(lái)第一遍估算結(jié)溫時(shí)比較有用。 在這個(gè)模型下,結(jié) 至電路板電阻就是測(cè)得的或建模獲得的 θjb值。 結(jié)至外殼表面的電阻就是測(cè)得的或建模獲得的 θjc值。 環(huán)境電 阻,Ra,可從封裝頂部的對(duì)流熱損耗和輻射損耗計(jì)算得出。
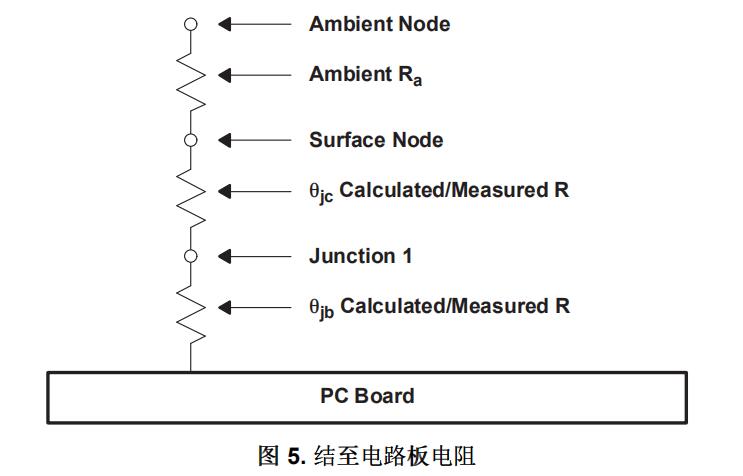
對(duì)于一個(gè)完整的系統(tǒng)仿真,電路板應(yīng)該進(jìn)一步包含于電路板材料、走線、熱導(dǎo)孔等相關(guān)的熱傳導(dǎo)電阻,以實(shí) 現(xiàn)圖 6中顯示的系統(tǒng)中的每個(gè)封裝的結(jié)溫計(jì)算。 PCB 至環(huán)境的熱阻應(yīng)該由很多分布電阻表示,對(duì)于這個(gè) 圖,這些分布電阻被搜集在一起成為 PCB 至環(huán)境電阻。
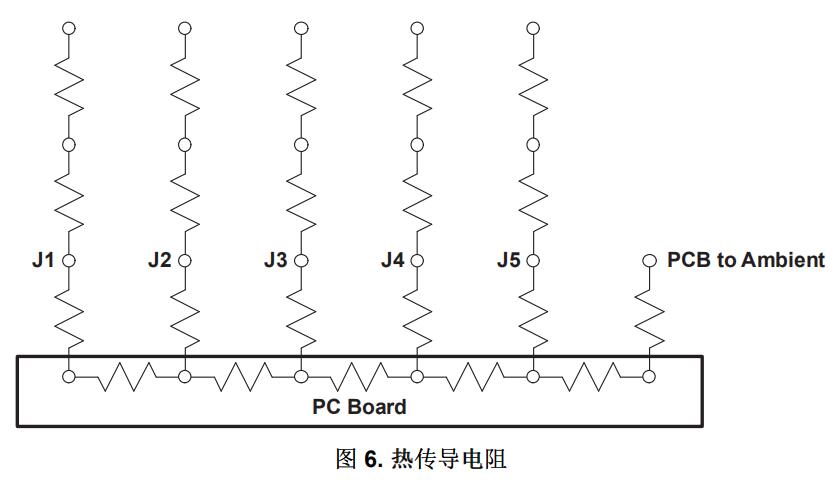
使用 θjb在一個(gè)比上面顯示的模型更加詳細(xì)的模型中計(jì)算系統(tǒng)結(jié)溫的問(wèn)題在于確定如何重新分配信號(hào)熱阻節(jié) 點(diǎn),這個(gè)節(jié)點(diǎn)將 θjb端接在系統(tǒng) PCB 上的封裝上。 在使用空間陣列封裝的情況下,芯片、封裝和電路板緊密的熱連接在一起,以至于將封裝熱連接表示為一個(gè)點(diǎn)是錯(cuò)誤的。 一個(gè)常見(jiàn)的解決方案是將封裝下方的 PCB表面與一盤(pán)非常高的熱傳導(dǎo)性材料短接在一起。 這引入了錯(cuò)誤。 另外一個(gè)解決方案是在電源和 PCB 之間包 含一個(gè)封裝尺寸大小的固體材料塊。 計(jì)算了這個(gè)塊的傳導(dǎo)性以給出電源和系統(tǒng)電路板之間的合適 θjb熱阻。 在歐盟的 ESPIRIT 集團(tuán)的贊助下,已經(jīng)在歐洲完成了被稱(chēng)為緊湊模型的封裝,此封裝使用少量的模擬熱阻[2]。 緊湊模型使用一個(gè)更加精密的熱阻網(wǎng)絡(luò)來(lái)更加準(zhǔn)確地表示封裝散熱性能。 現(xiàn)在,緊湊模型常見(jiàn)于大多 數(shù)系統(tǒng)級(jí)散熱建模工具,并可向 TI 索取。
測(cè)量 θjb的主要方法如下:
Step 1. 包含一個(gè)散熱測(cè)試芯片的測(cè)試包被安裝在測(cè)試板上。
Step 2. 一個(gè)細(xì)規(guī)度熱電偶(36-40 規(guī)度)被粘結(jié)或焊接在最靠近芯片的器件引腳上。 在使用 BGA 封 裝的情況下,熱電偶被焊接或粘結(jié)到最接近芯片的封裝邊沿下的走線上。
Step 3. 電路板被固定在一個(gè)特殊的雙冷卻盤(pán)裝置內(nèi),此裝置在封裝和冷卻盤(pán)表面具有隔熱層,但是在 冷卻盤(pán)與電路板之間有熱觸點(diǎn)。 冷卻盤(pán)為 PCB 散熱。
Step 4. 功率在芯片內(nèi)耗散。
Step 5. 芯片和引腳的溫度被監(jiān)視。
Step 6. 當(dāng)實(shí)現(xiàn)了穩(wěn)定狀態(tài)時(shí),結(jié)至引腳間溫度的 delta 除以總功率耗散。 在 EIA/JESD 51-8 中對(duì)這個(gè)過(guò)程進(jìn)行了更加準(zhǔn)確的定義。

、
Ψjb 的概念與 Ψjt相似。 它是指結(jié)溫和中央封裝引腳溫度間差異的測(cè)量,除以器件的功率耗散。 這樣的話, 它不是真正的熱阻,這是因?yàn)橥ㄟ^(guò)這個(gè)熱阻的功率實(shí)際分割是未知的。
Ψjb使得系統(tǒng)設(shè)計(jì)人員能夠用一個(gè)細(xì)規(guī)度熱電偶來(lái)測(cè)量電路板溫度,并反過(guò)來(lái)使用公式 9計(jì)算結(jié)溫。 應(yīng)該注 意的是,由于器件熱量的 70%-95% 由 PCB 散發(fā),Ψjb接近 θjb。
![]()
Ψjb的測(cè)量由 EIA/JESD 51-6 定義。 在選擇熱偶類(lèi)型、規(guī)度時(shí)應(yīng)該小心,并且在將熱電偶穿過(guò) PCB 時(shí),應(yīng) 該采用與熱電偶測(cè)量外殼溫度用于 Ψjt測(cè)量時(shí)所用的方式相類(lèi)似的方式。 在進(jìn)行 Ψjt測(cè)量時(shí),IR 攝像機(jī)或光 線探測(cè)器可被用來(lái)測(cè)量 PCB 溫度。 然而,由于圖像采集點(diǎn)的尺寸太小,所以 IR 散熱槍式探測(cè)器不太適 用。
標(biāo)記有工業(yè)用溫度范圍的德州儀器 (TI) 器件工作在 -40°C 的 85°C 環(huán)境溫度下,此時(shí)要小心謹(jǐn)慎以確保不超 過(guò)絕對(duì)最大運(yùn)行溫度。 請(qǐng)注意,系統(tǒng)級(jí)散熱設(shè)計(jì)被要求規(guī)定不超過(guò)最大運(yùn)行器件溫度,即使輸入環(huán)境空氣溫 度介于 -40°C 和 85°C 之間時(shí)也是如此。 當(dāng)工業(yè)用溫度范圍被指定時(shí),最小運(yùn)行溫度為 -40°C。 由于沒(méi)有 定義工業(yè)用溫度含義的行業(yè)標(biāo)準(zhǔn),所以公司和公司之間會(huì)有可能存在變化。 標(biāo)記有商用溫度范圍的德州儀器 (TI) 器件工作在 0°C 的 70°C 環(huán)境溫度下,此時(shí)要小心謹(jǐn)慎以確保不超過(guò)絕 對(duì)最大運(yùn)行溫度。 當(dāng)商用溫度范圍被指定時(shí),最小運(yùn)行溫度為 0°C。
結(jié)溫— 封裝內(nèi)硅芯片的最高溫度。
建議運(yùn)行溫度— 器件在設(shè)計(jì)使用壽命內(nèi)持續(xù)運(yùn)轉(zhuǎn)在指定性能時(shí)的結(jié)溫。 如果器件在高于這個(gè)溫度的環(huán)境內(nèi) 運(yùn)行,器件的可靠性有可能會(huì)降級(jí)。 某些器件將在這個(gè)溫度以上不能工作。 其它偶爾會(huì)用到的措辭 是建議持續(xù)運(yùn)行結(jié)溫。
絕對(duì)最大運(yùn)行溫度— 器件可供電運(yùn)轉(zhuǎn)的最大結(jié)溫。 如果器件持續(xù)運(yùn)轉(zhuǎn)在這個(gè)溫度下,器件的使用壽命會(huì)減少。 其它偶爾會(huì)用到的措辭最大運(yùn)行溫度。
絕對(duì)最大結(jié)溫— 超過(guò)這個(gè)溫度,器件會(huì)出現(xiàn)損壞。 器件在這個(gè)溫度上有可能不能工作或達(dá)到預(yù)期的性能。
最大外殼溫度— 有時(shí),給出一個(gè)最大外殼溫度,而不是指定最大運(yùn)行溫度。 在最大外殼溫度上運(yùn)行器 件(無(wú)散熱片)會(huì)導(dǎo)致芯片運(yùn)行在建議運(yùn)行結(jié)溫上。 有時(shí),這被寫(xiě)成 T外殼。 T外殼通常在封裝頂部表面 的中央進(jìn)行測(cè)量。
周?chē)諝鉁囟取?對(duì)個(gè)源列出了不同的位置以確定周?chē)h(huán)境溫度 NEBS 將進(jìn)入系統(tǒng)盒中的空氣溫度指定為環(huán) 境空氣溫度。 AEC 將器件下方的空氣溫度指定為環(huán)境空氣溫度。 JEDEC 指定 PCB 之前的空氣流溫 度。 有時(shí),在器件的上方測(cè)量環(huán)境空氣溫度,作為對(duì)環(huán)境的理解。 這些測(cè)量位置中的每一個(gè)都產(chǎn)生 一個(gè)針對(duì)環(huán)境空氣溫度的不同溫度。 在任何情況下,影響器件穩(wěn)定性和功能性的關(guān)鍵因數(shù)是結(jié)溫,而 不是環(huán)境溫度,理解這一點(diǎn)很重要。 由于結(jié)溫和環(huán)境溫度是互相關(guān)聯(lián)的,在采取任何系統(tǒng)級(jí)分析前, 澄清環(huán)境溫度假設(shè)十分關(guān)鍵。